集成电路温度循环试验(Temperature Cycling)是将产品放入高、低温交替环境中循环多次后验证其功能是否正常的一项环境试验。其试验原理是产品在设定的上下限温度内循环时,由于热胀冷缩的原因,产生交互膨胀和收缩,使得产品产生热应力和应变。
为了探究集成电路受快速温度变化的影响,我们使用温度循环变化试验箱对其做温度循环测试,下面是主要试验内容。
试验设备:环仪仪器 温度循环变化试验箱

试验条件:-65℃~150℃,高低温转换时间15分钟,温变速率约14.3℃/min。高低温各15分钟,试验中每100个循环进行电参数测试确认。
试验样品见下表:
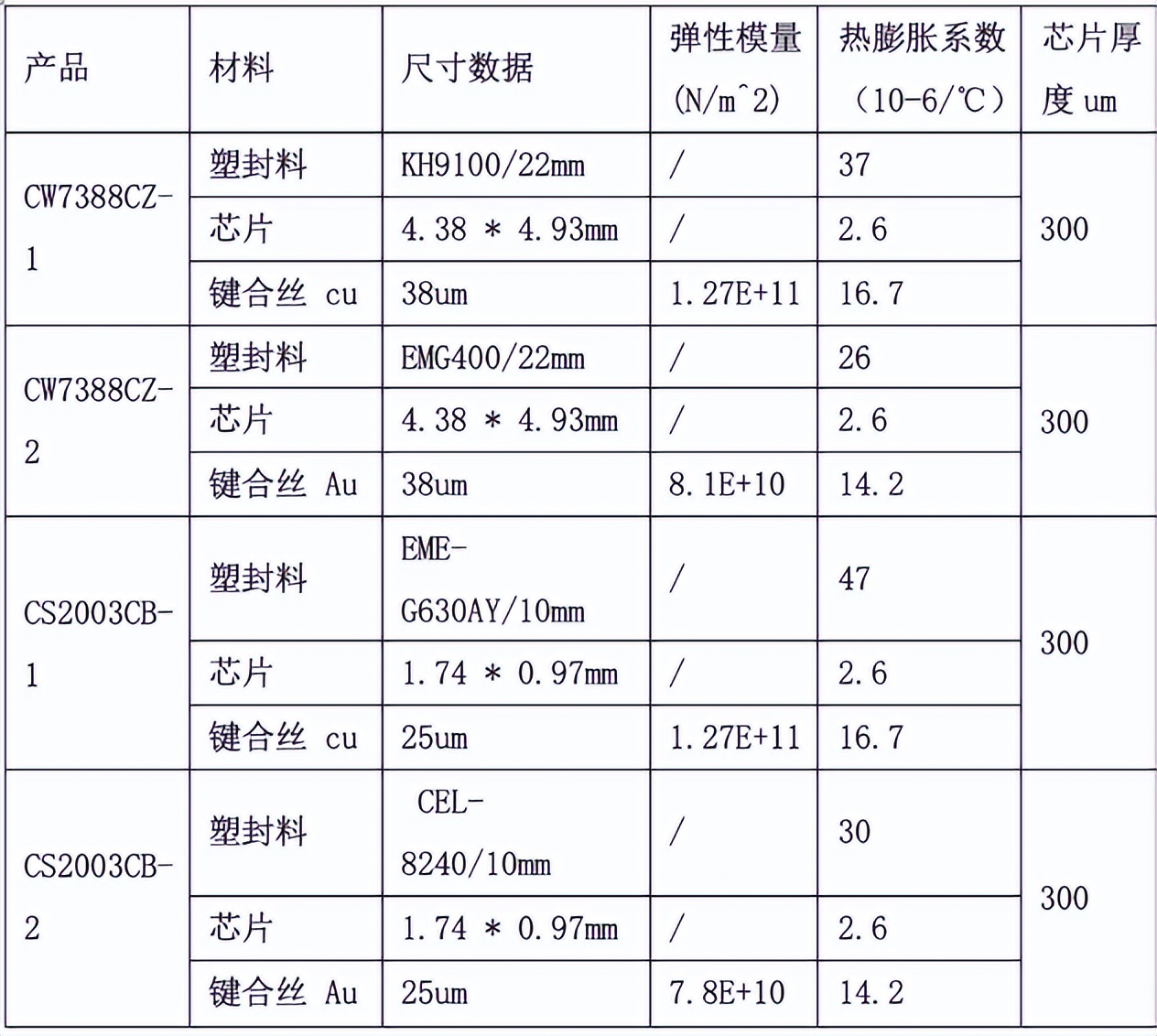
试验结果如下表所示:

试验结果:
从试验结果看到,大尺寸芯片预估芯片对角寿命比焊点寿命更短,而小芯片则反之,实际的寿命表现也符合计算结果,通过对失效样品的分析结果看,CW7388的失效样品确实都是属于芯片对角位置受损,而CS2003失效都是焊点断裂或脱落。失效样品FA情况见下图:

总结:
温度循环试验是集成电路可靠性不可或缺的试验项目,然而温度循环是属于破坏性试验,其试验条件的选择要匹配产品的设计规格,特别是进行可靠性筛选时要严格注意防止过应力产生,造成新的失效模式,故筛选时对产品的设计参数要进行了解,温度循环数不宜过多避免产生疲劳失效。
如有集成电路的可靠性试验疑问,可以咨询环仪仪器相关技术人员。
