绝缘栅双极晶体管(insulated gate bipolar tran‐sistor,IGBT)是一种功率半导体器件,以其耐高压、功耗低、开关时间短等优点。温度冲击测试(TST)是IGBT模块可靠性测试的一种重要手段。下面,我们通过研究其热冲击特性,探索其组织演变与裂纹扩展。
试验设备:环仪仪器 高低温气体冲击热流罩

实验材料:Si基IGBT芯片,尺寸为 4.73 mm×6.01 mm×0.30mm;芯片背面的镀层为 Ti0.1 μm/Ni0.3 μm/Ag0.4 μm。采用纯铜引线框架,尺寸为16.9mm×14.0 mm×2.0 mm。
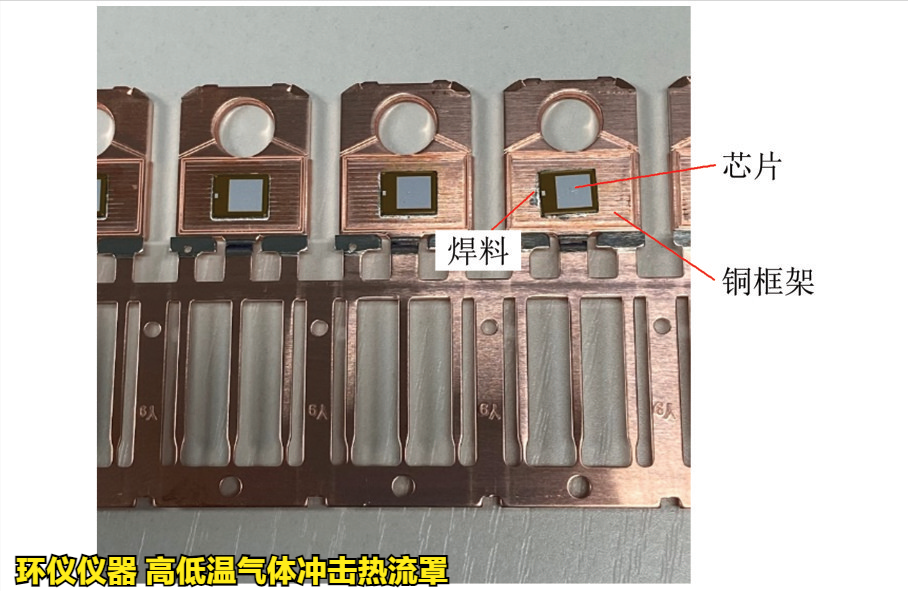
温度冲击条件:
根据联合电子器件工程委员会(JEDEC)的标准,常用的温度系统为低温(-65 ℃ )与高温(150 ℃),循环周期为 30 min,高低温时间各为11.5 min。
试验分析:
500次和 750次温度冲击后的组织如下图所示,可以发现:温度冲击次数越多,焊料层界面处的Ag3Sn就越多;上界面处的金属间化合物从离散分布到连成一片,下界面的Cu3Sn变厚,并出现越来越多的 Ag3Sn。
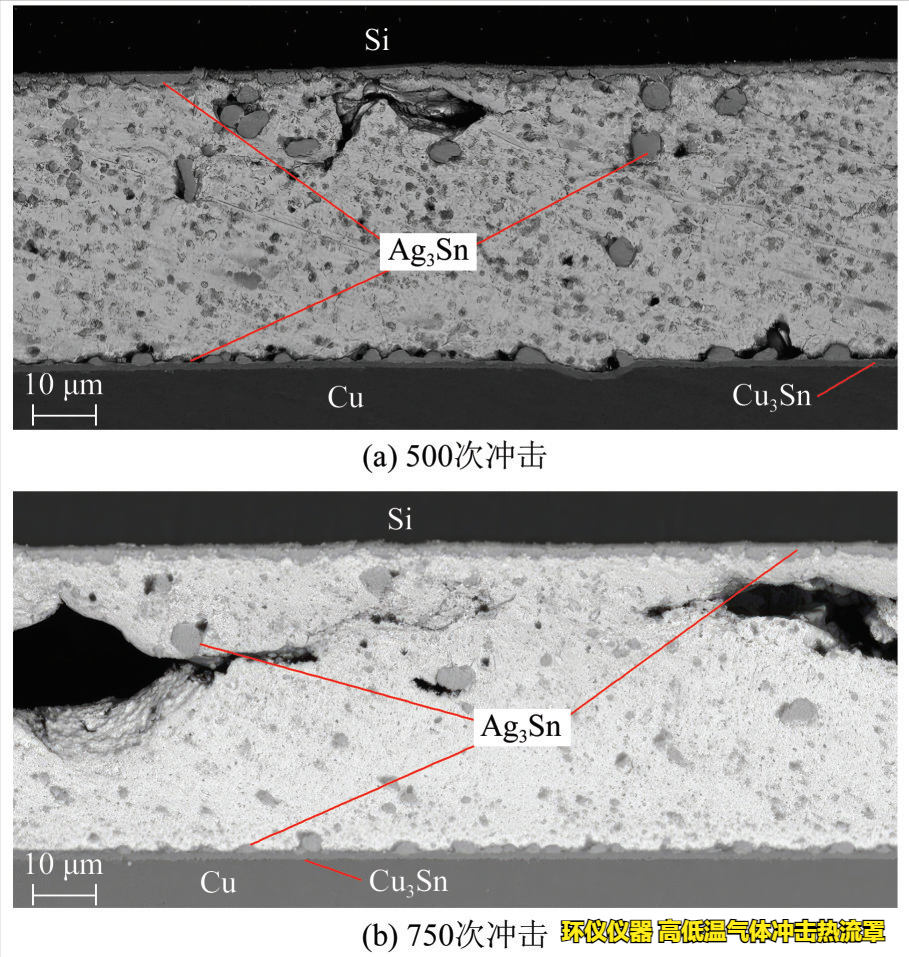
除此之外,焊料基体中也存在大量由界面上脱离的 Ag3Sn,下图为 Ag3Sn 脱离示意图:
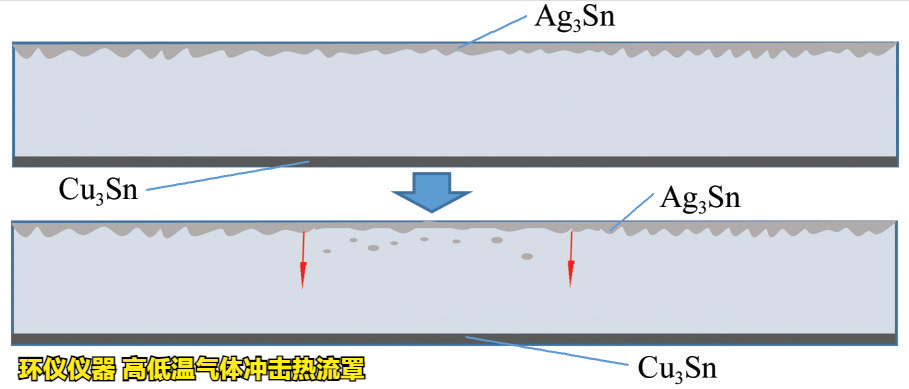
实验总结:
1.焊料界面上的金属间化合物会随着温度冲击次数的增加而增加。
2.温度冲击会导致焊料内的 Ag3Sn脱离界面,向焊料基体中移动,其中Ag3Sn的移动速率更快,这也会导致焊料内产生应力集中,降低焊料的可靠性。
3.在250次温度冲击后焊料内出现裂纹,裂纹从焊料层与芯片界面的边角萌生,并沿界面向焊料层中心扩展。
如需了解更多高低温气体冲击热流罩的试验研究,可以咨询环仪仪器相关技术人员。
